|
 Introduction
Introduction
-
MicroscopyЖѕ? : MicroscopesИІ ЛчПыЧЯПЉ ЙАУМРЧ morphologyПЭ fine
structureИІ ПЌБИЧЯДТ АЭ.
АэКаРк БИСЖРЧ ХЉБтПЭ visibilityЕюРЬ microscopyИІ ШАПыЧЯПЉ ШЎРЮЕШДй.
(ex:
БИСЄ(spherulites)РЧ ЛчРЬСюПЭ КаЦїЕЕ БЄЧаБтМњЗЮ АќТћЕЩ Мі РжДй.)

FIg.1
(A) TEMАњ (B) Optical microscopyРЧ КёБГ.
 Lenses in the microscope
Lenses in the microscope
-
Magnetic lenses : Glass lensesПЭ РЏЛчЧЯАд Бз РЇФЁИІ ЙйВйБт
КИДй powerИІ КЏШНУХДРИЗЮНс ЦїФПНЬРЬ ИТУчСіДТ
ЗЛСю.
-
Condenser lens : filamentЗЮ КЮХЭ ЙцУтЕЧДТ РдЛчБЄРЛ ШПАњРћРИЗЮ И№РИДТ
ПЊЧвРЛ ЧЯДТ ЗЛСю.
-
Objective lens : НУЦэРЛ ХыАњЧЯАэ Г ШФ, ЛъЖѕЕШ РдЛчБЄРЛ И№РИДТ ЗЛСю.
-
Eyepiece lens : ДЋПЁ НЧЛѓ(virtual image)ИІ ЧќМКНУХАДТ ЗЛСю. БЄЧаЧіЙЬАцРЧ
АцПь projector lensАЁ
ЛчПыЕШДй.
 Optical Microscopy
Optical Microscopy
-
СЄРЧ : КћАњ ЙАУМ ЖЧДТ НУЦэЛчРЬРЧ ЛѓШЃРлПы (interaction)ПЁ РЧЧи Лѓ(image)РЬ
ИИЕщОюСіДТ ЧіЙЬАц.
-
ЦЏТЁ : 1) АќТћЕЧДТ ЛѓРК 2ЙшПЁМ 2000ЙшСЄЕЕРЧ ЙшРВ ЙќРЇЗЮ НУЦэРЧ ММЙаЧб
ЧЅЧіРЛ БИЧіЧи ГО Мі РжДй.
2)
0.5РЧ resolution РЬ
АЁДЩЧЯИч НУЦэИЖДйРЧ ЦЏМКАњ objective lensПЭ КћРЧ ЦФРхПЁ ЕћЖѓ СІЧбЕШДй.
3)
ОђОюСіДТ
СЄКИДТ КИХы АЁНУЙА(visible features)РЧ БцРЬ, ЧќХТ БзИЎАэ ЛѓДыРћРЮ
ЙшП(arrangement)ЕюАњ АќЗУЕШ
АЭЕщРЬДй. КЙБМР§(birefringence)РЬГЊ БМР§ЗќСіМі(reflective index)ААРК
ЛѓМіРЧ УјСЄЕЕ АЁДЩЧЯДй.
4)
ЧЯГЊ ШЄРК Бз РЬЛѓРЧ БЄПјАњ НУЦэПЁ БЄМБРЛ ИТУпДТ ПЉЗЏ АЁСі ЗЛСюЗЮ
БИМКЕЧОю РжРИИч ЛѓЕщРК ЛчСјРЬГЊ video
tapeЕюРИЗЮ БтЗЯЕЧДТ АЭРЬ КИХыРЬДй.
-
СОЗљ : simple microscopes, stereo microscopes
-
БМР§ЗќСіМіРЧ УјСЄ : БМР§Зќ СіМі(n)РК БЄЧаЧіЙЬАцРИЗЮ НБАд УјСЄРЬ
ЕЧИч ОЫЗССіСі ОЪРК ЙАСњРЛ ШЎРЮЧЯДТЕЅ РЏПы.
БМР§Зќ
СіМіАЁ ОЫЗССј liquidРЇПЁ РдРкЕщРЛ ПУИА Ек, transmissionРИЗЮ АќТћЧбДй.
transparent
ЖЧДТ translucent РдРкАЁ ИХПь ГЗРК contrastИІ АЁСњ ЖЇ liquidДТ n(liquid)=n(particle)АЁ
ЕЩ ЖЇБюСі ЙйВюАд ЕШДй. Бз КЏШАЁ nАЊРЛ СѕАЁНУХАДТСі АЈМв НУХАДТСіИІ
АсСЄЧЯБт РЇЧиМ sampleПЁ КёНКЕыЧЯАд СЖИэРЛ НУХВДй. РЬЖЇРдРкДТ lensesЗЮ
РлПыЧЯАэ, n(liquid)<n(particle)РЯ ЖЇДТ МіЗХЗЛСю(converging
lenses)ЗЮ РлПыЧбДй. АсСЄРЧ Чб ИщПЁ КћРЬ СЖЛчЕЧИщ УрПЁ ЕћЖѓ РќШЏЕЧИч
Бз ИщРК ЙрАд ЕЩ АЭРЬДй. РЬ ИэОЯРК n(liquid)>n(particle) РЯ ЖЇ ЙнДыАЁ ЕШДй.
МБХУРћРИЗЮРдРкРЧ sharp
boundariesРЧ axial illuminationРК edgeКЮБйПЁ СМРК КћРЧ Жь, Ся
Becke lineРЛ КЮПЉНУХВДй. КћРК nАЊРЬ Дѕ ХЋ ИщПЁМ ЛъЖѕЕЧИч
ЦїФПНКАЁ РдРкРЇПЁ РжРЛ ЖЇ Бз ИщПЁ lineРЬ ГЊХИГЊИч, РдРк ОЦЗЁРЯ
ЖЇДТ ДйИЅ ИщПЁ ГЊХИГДй. Phase contrastДТ nАЊРЧ ТїРЬПЁ РЧЧи contrastИІ
СѕАЁНУХАИч КИДй СЄШЎЧб АсАњИІ ОђАд ЧиСиДй. TransmissionПЁМРЧ
interference contrastДТ optical path lengthПЭ НУЦэ ЕЮВВИІ ХыЧб ЦђБе
БМР§Зќ СіМіАЊРЛ ОђАд ЧиСиДй. ЦЏШї Becke line ЙцЙ§РЛ ХыЧиМДТ
ЧЅИщ БМР§ЗќСіМіАЊРЛ ОђРЛ Мі РжДй.
 Scanning electron microscopy (SEM)
Scanning electron microscopy (SEM)
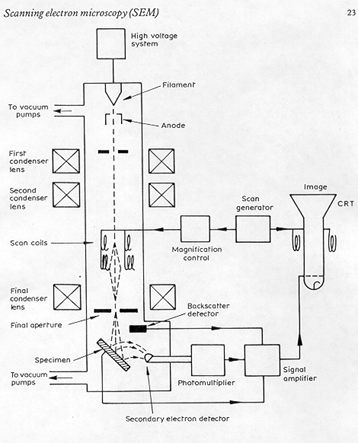
Fig.2
SEMРЧ ЕЕНФЕЕ
-
СЄРЧ : scanning microscopyРЧ БтКЛРћРЮ ЦЏТЁРК probeАЁ НУЦэРЛ СіГЊАЁИчИч
scanningРЛ ЧдРИЗЮНс СЁДыСЁ(ponit by point)РИЗЮ ЛѓРЬ
ЧќМКЕШДйДТ АЭРЬДй. РЬЖЇ probeДТ РќРкКі (electron beam)РЬАэ АќУјЕЧДТ
signalРК TV ХИРдРЧ ЛѓРИЗЮ ГЊХИГЊАд ЕШДй. Display tubeГЛРЧ РќРкКіРК
НУЦэРЧ probeПЭ ЕПНУПЁ ПђСїРЮДй.
-
ЦЏТЁ : 1) ЙшРВРК (linear size of the image / size of the region
scanned on the specimen)РИЗЮ АсСЄЕЪ. ЕћЖѓМ ЙшРВРК
focusААРК ЛѓРЧ СЖАЧПЁ ПЕЧтОјРЬ ЙйВм Мі РжДй.
2)
БЄЧаЧіЙЬАцКИДй Дѕ ГєРК resolutionРЛ АЁСіИч chamberГЛРЧ НУЦэЕЕ ХЉАэ
Мі mmПЁМ Мі inchБюСі СїАцЕЕ АЁДЩЧЯДй.
3)
sample СиКёАЁ РЯЙнРћРИЗЮ ИХПь АЃДмЧЯДй.
4)
РЯЙнРћРЮ polymerЕщАњ ААРК КёРќЕЕМК ЙАСњЕщРК ГЗРК АЁМгРќОаРЛ ЛчПыЧЯАХГЊ
РќЕЕ ФкЦУРЛ ПфБИЧбДй.
5)
ЛѓРЧ ЧќХТДТ interactionАњ detector, signal processingЕюПЁ РЧСИЧбДй.
6)
Spatial resolutionРК signalРЬ РЏЕЕЕЧДТ НУЦэ ПЕПЊРЧ ХЉБтЗЮ АсСЄЕШДй.
РЬАЭРК interaction volumeАњ
АќЗУ
ЕЧОю РжРИИч РЬАЭРК НУЦэАњ КіРЬ МЗЮ ЛѓШЃРлПыЧЯДТ ПЕПЊРЛ РЧЙЬЧбДй.
(ex:
radiation sensitivityИІ ЛчПыЧЯПЉ PMMAПЁ 20 keV РќРкРЧ interaction
volumeРЛ ЧќМКНУХАДТ АцПьИІ Л§АЂЧи
КИРк. ЙАСњПЁ РќРкКіРЛ ГыУтНУХВ ШФ ММУДАњ etchingРЛ НУХАИщ Йш(pear)И№ОчРЧ
10m БэРЬЗЮ Л§Бф holeРЬ
КіАњ ЛѓШЃРлПыЧЯДТ PMMA ПЕПЊРЛ КИПЉСиДй. РќРкКіАњРЧ ЛѓШЃРлПыРЛ АшЛъЧЯИщ
ГєРК АЁМгРќОаАњ
НУЦэРЧ ГЗРК ПјРкЙјШЃПЁ ДыЧи interaction volumeРЬ СѕАЁЧЯДТ АЭРЛ КИПЉСиДй.)
7)
НУЦэРИЗЮКЮХЭРЧ СпПфЧб signalПЁДТ backscattered electronsАњ 2ТїРќРкПЭ
x-rayЕюРЬ РжДй. backscattered
electronsРК sampleГЛРЧ ЧйПЁ РЧЧи elasticЧЯАд ЛъЖѕЕЧИч ЧЅИщРИЗЮКЮХЭ
ЙпЛ§ЧбДй. 2ТїРќРкДТ
ГЗРК ПЁГЪСі, Ся 50eVРЬЧЯПЁМ НУЦэРИЗЮКЮХЭ ЙцУтЕШДй. ИИОр КіРЬ tilted
surface ЖЧДТ edgeПЁ РћПыЕШДйИщ
КИДй ИЙРК 2ТїРќРкАЁ НУЦэПЁМ ЙцУтЕШДй. ИИОр КіРЬ ЧЅИщРЧ БМАюСј КЮКаРЬГЊ
holeКЮКаПЁ СЖЛчЕЧИщ
ЧЅИщ БйУГРЧ interaction volumeРЬ РћОюСЎМ ЙпЛ§ЕЧДТ 2ТїРќРк МіЕЕ
РћАд ЕШДй. 1ТїКіПЁ РЧЧи ИИЕщОюСіДТ
2ТїРќРкДТ high resolution topographic imagesИІ СІАјЧбДй. РЬ 2ТїРќРкПЁ
РЧЧб imaging (SEI:
secondary electron imaging)РК signal formationАњ collectionРЧ ШПРВМК
ЖЇЙЎПЁ SEMПЁ ЦјГаАд РЬПыЕШДй.
8)
PMMAПЭ ААРК polymerЕщРК ИХПь beam sensitiveЧЯИч rastered areaЗЮ
КЮХЭРЧ 'picture frame constrast'РК
СњЗЎ МеНЧПЁ РЧЧи ШчЧЯАд ГЊХИГДй. ЙнАсСЄМК АэКаРкЕщРК РќРкКіРЧ ГыУтПЁ
РЧЧи Бз АсСЄМКРЛ
РвАэ НУЦэРЧ morphologyИІ КЏШНУХГ Мі РжДй. ГЗРК АЁМгРќОаРК charging
effectsПЭ beam penetrationАњ
beam damageИІ АЈМв НУХВДй.

Fig.
3 (A) АэУМ НУЦэАњ РдЛчЕШ РќРкКіРЧ ЛѓШЃРлПы (B) CarbonГЛРЧ electron
pathИІ АшЛъЧЯПЉ (A)РЧ СЄШЎЧб АцАшПЭ РБАћРЛ ШЎРЮ Чв Мі РжДй.
-
Optimization ЙцЙ§ : stable specimensПЁ ДыЧб SEM operationРЧ УжРћШПЁ
АэЗСЧиОп ЕЩ СпПфЧб ИюАЁСіДТ noiseПЭ depth
of fieldПЭ resolutionРЬДй. РЬЗБ КЏМіЕщРК beam voltage, beam current,
final aperture sizeПЭ
working distanceЕюПЁ РЧЧи ДоЖѓСіИч, УжДы resolutionРЧ СЖАЧРК
1)
high accelerating voltage
2)
ТЊРК working distanceПЭ РлРК final apertureЗЮ ОђОюСіДТ small
probe
3)
ГЗРК noiseПЁ УжРћРЮ high beam current
4)
probe sizeАЁ РлАэ ГЗРК РќЗљРЯ ЖЇДТ Бф ГыУтНУАЃРЬ ЧЪПф.
ЖЧЧб
УжДыРЧ depth of field(=focusГЛПЁ РжДТ НУЦэРЧ ЕЮВВ ШЄРК БэРЬ)ИІ РЇЧб
СЖАЧРК
1)
long working distance
2)
small final aperture size
3)
large probe size
ЕюРЬДй.
-
Operation : SEMПЁМДТ ЕЮВЈПю БнМгФкЦУАњ ИХПь ГЗРК АЁМгРќОаРЬ polymerПЁ
ЕЕДоЧЯДТРќРкРЧ ДыКЮКаРЛ ИЗРЛ
Мі РжДй. ЕЮВЈПю ФкЦУАњ ГЗРК beam voltageДТ SEM imageРЧ resolutionРЛ
ГЗУпАд ЕШДй. ИИРЯ 5~10kVРЧ
РќРкАЁ ЛчПыЕЧАэ РЬЕщРЬ polymerИІ АќХыЧбДйИщ shapeРЧ fine scale changeАЁ
РЯОюГЊАд ЕШДй.
SEMПЁМ damageИІ УжМвШЧЯАэ imagingРЛ ЧтЛѓНУХГ Мі РжДТ СЖАЧРК
1)
ГЗРК АЁМгРќОа
2)
ГЗРК beam current
3)
large probe size
4)
ГаРК ПЕПЊПЁ ДыЧб ГЗРК ЙшРВ
5)
ТЊРК ГыУт НУАЃ
6)
ГыУтЛчРЬРЧ beam blanking
 Transmission electron microscopy (TEM)
Transmission electron microscopy (TEM)
-
СЄРЧ : НУЦэРЬ РќРкКіПЁ РЧЧи illuminateЕЧДТ light microscopeПЭ РЏЛчЧб
РќРк БЄЧа РхКё.
-
ЦЏТЁ : 1) Air scatters electrons ЖЇЙЎПЁ СЖРлРЛ ЧиОп ЧбДй.
2)
РќРкРЧ ТЊРК ЦФРх ЖЇЙЎПЁ high resolutionРЬ АЁДЩ.
3)
Image contrastДТ РќРк ЛъЖѕ (electron scattering)ПЁ БтРЮЧбДй. НУЦэГЛРЧ
РќРкКіРЧ ШэМіДТ ШчФЁ ОШСіИИ БЄАЂПЁМРЧ
РќРкЛъЖѕРК bright fieldПЁМ ЛѓПЁ ПЕЧтРЛ ЙЬФЁСі ОЪРИИч ШэМіЕЧДТ АЭРИЗЮ
АќТћЕШДй. БдФЂРћРЮ
ЖЧДТ АсСЄМКРЮ ЙАСњПЁМ РЬ РќРк ЛъЖѕРК diffraction constrastИІ
КЮПЉЧЯИч АсСЄ ЙшЧтПЁ АЧЯАд ПЕЧтРЛ
ЙЬФЃДй. amorphous materialРЧ mass thickness contrast resultПЁМ,
image brightnessДТ local
mass thickness (thickness X density)ПЁ РЧСИЧбДй.
4)
ContrastДТ ГЗРК АЁМгРќОаАњ РлРК objective aperture diametersПЁМ
Дѕ ХЉДй. ИИРЯ ЛъЖѕЕШ РќРкАЁ ЛѓПЁ
ПЕЧтРЛ ЙЬФЁСі ОЪДТДйИщ phase contrastПЁ БтРЮЧб ПЕЧтРЛ ЙЬФЁАд ЕЩ
АЭРЬДй.
5)
polymerДТ ДыУМЗЮ ГЗРК ПјРкЙјШЃИІ АЁСіАэ ЛъЖѕЕЧДТ РќРкАЁ ОрЧиМ TEMПЁМРЧ
contrastДТ СССі ИјЧЯДй.
РЬЕщ(polymer)РК ГєРК beam sensitivityИІ АЁСіИч radiation damageДТ
АсСЄРЧ БдФЂМКРЧ ЦФБЋИІ
ОпБтНУХВДй. АЁМгРќОаРЛ ГєРЬАэ НУЦэРЛ coolingНУХАИщ contrastИІ ГєРЬДТ
ЙцЙ§РЬ ЕЧМ ЛѓШВРЛ ССАд
ИИЕщ Мі РжДй.
-
Opearation
1)
low dos methods : TEMПЁМ noiseРЧ ЙпЛ§РК СжЕШ ЙЎСІАЁ ЕЧИч ЕћЖѓМ
imageИІ ЧќМКНУХАБт РЇЧи И№Еч АЁДЩЧб
РќРкИІ ЛчПыЧЯДТ АЭРЬ СпПфЧЯДй. РЬЗИАд ЧЯБт РЇЧи low dos methodИІ
ЛчПыЧбДй. РЬЙлПЁ ЛѓБтЧиОпЕЩ ИюАЁСіИІ
ЕчДйИщ
*
ЛѓРЬ БтЗЯЕЩ ЖЇИІ СІПмЧЯАя ЛѓРЬ ЕЧДТ ПЕПЊПЁ beamРЛ АэСЄЧЯЖѓ.
*
specimen doseПЭ БтЗЯИХУМРЧ sensitivityПЭ ЙшРВРЛ matchНУФбЖѓ.
2)
РЬЗаРћРЮ ЧбАшИІ ГбОюМ УжРћРЧ imaging conditionРЛ ОђБт РЇЧиМДТ
ДйРН ГзАЁСі ПфМвИІ НЩЕЕРжАд ГэРЧ
Чв ЧЪПфАЁ РжДй.
*
noise ratioПЁ ДыЧи ПфБИЕЧДТ signal
*
НУЦэРЬ УыЧв Мі РжДТ УжДы СЖЛчЗЎ
*
image contrast
*
ЛѓРЛ ЧќМКНУХАДТ РдЛчРќРкРЧ КаРВ
3)
Image processingРК original imageПЁ РжОюМ noiseКёПЁ ДыЧб signalРЛ
АЈМв НУХГ Мі РжДй. 
|
![]()
![]()